上述 HTCC、LTCC 及 MSC 基板线路层都采用丝网印刷制备,精度较低,难以满足高精度、高集成度封装要求,因此业界提出在高精度 DPC 陶瓷基板上成型腔体制备三维陶瓷基板。由于 DPC 基板金属线路层在高温 (超过 300°C) 下会出现氧化、起泡甚至脱层等现象,因此基于 DPC 技术的三维陶瓷基板制备必须在低温下进行。
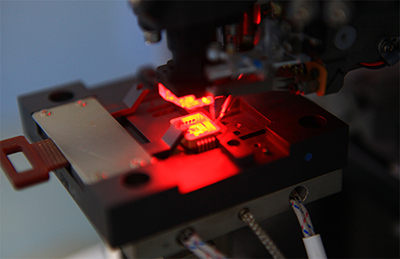
首先加工金属环和 DPC 陶瓷基板,然后采用有机粘胶将金属环与 DPC 基板对准后粘接、加热固化。由于胶液流动性好,因此涂胶工艺简单,成本低,易于实现批量生产,且所有制备工艺均在低温下进行,不会对 DPC 基板线路层造成损伤。
但是,由于有机粘胶耐热性差,固化体与金属、陶瓷间热膨胀系数差较大,且为非气密性材料,目前 DAC 陶瓷基板主要应用于线路精度要求较高,但对耐热性、气密性、可靠性等要求较低的电子器件封装。
为了解决上述不足,业界进一步提出采用无机胶替代有机胶的粘接技术方案,大大提高了 DAC三维陶瓷基板的耐热性和可靠性。其技术关键是选用无机胶,要求其能在低温 (低于 200°C) 下固化;固化体耐热性好 (能长期耐受 300°C 高温),与金属、陶瓷材料粘接性好 (剪切强度大于 10 MPa),同时与金属环 (围坝) 和陶瓷基片材料热膨胀系数匹配 (降低界面热应力)。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。