系统级封装技术能够将不同类型的元件通过不同的技术混载于同一封装之内,是实现集成微系统封装的重要技术,在航空航天、生命科学等领域中有广阔的应用前景。陶瓷基板材料是系统级封装技术的基础材料之一。本文介绍了系统级封装技术的概念及其特点,分析几种系统级封装用陶瓷基板材料的优缺点,同时指出了陶瓷基板材料的未来发展趋势。
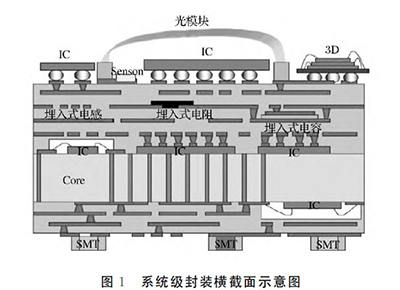
随着以电子计算机为核心、集成电路产业为基础的现代信息产业的发展,以及便携式通讯系统对电子产品的迫切需求,电子产业得到了迅猛发展,同时也带动了与之密切相关的电子封装的发展。电子封装技术直接影响着电子器件和集成电路的频率、功耗、复杂性、可靠性和成本等,因此成为电子领域的关键技术。
电子封装是指实现互连和对半导体芯片实现供电、冷却和保护的整个过程。随着电子元器件和电路组件继续向高密度、高速度、低功耗、高频、大功率、宽工作温度范围、抗辐射和高可靠性方向发展,其对电子封装技术提出了更高的要求。
系统级封装(SIP)技术是指将不同类型的元件通过不同的技术混载于同一封装之内。图1给出了某种典型的SIP高密度电子集成模块的横切面,这是在一块核心基板(Core)上根据需要逐层造出各元件连线层,各有源无源元件埋入层,光学系统层等;再在造好的基板上用倒装形式(Flip-Chip)或线焊(Wire-Bonding)方式安装上各个IC和MEMS,也包括不能埋入的无源元件和传感器。根据上述实例SIP具有以下优点:①封装效率高,可在同一封装体内加多个芯片,减少了封装体积;②兼容性好,实现了不同的工艺、材料制作的芯片封装成一个系统,并可实现嵌入集成无源组件的梦幻组合;③电性能好,SIP技术可以使多个封装合为一体,这样在减少了总的焊点数的同时显著减小了封装体积、重量,缩短了组件的连接路线,提高了电性能;④SIP可提供低功耗和低噪音的系统级连接,在较高的频率下工作可获得几乎与系统级芯片(SOC)相等的总线宽度;⑤系统成本低、开发时间短,由于可以大量采用成熟器件,SIP无论从研发成本、生产成本方面和研发周期方面均低于SOC。
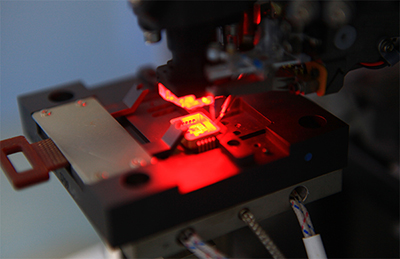
但是,SIP是一庞大的系统工程,涉及到多种材料(半导体材料、陶瓷材料、金属材料、金属基复合材料)、多种芯片(逻辑芯片、数字芯片、模拟芯片、功率芯片)、多种互连(高密度多层互连、芯片与芯片互连、倒装焊、线键合)、多种封装(BGA、CSP、无源集成)、多种组装(封装堆叠、芯片堆叠、高精度组装)和多种测试(裸片测试、封装测试、系统测试)等。其中,陶瓷基板材料是SIP的基础材料之一,对电路起到支撑和绝缘的作用,如图1中大部分灰色部分均由陶瓷材料组成。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。