SIP芯片堆叠后发热量将增加,但散热面积相对并未增加,因而发热密度大幅提高,而且由于热源的相互连接,热耦合增强,从而造成更为严重的热问题。同时,内埋置基板中的无源器件也有一定的发热问题。因此,SIP在封装体积缩小、组装密度增加的同时必然带来散热的问题,选择散热效果更好即热导率更高的陶瓷材料是实现SIP的关键。
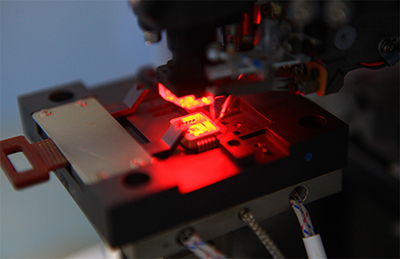
AIN陶瓷具有较高的热导率,其膨胀系数与Si材料更匹配,且介电常数低,适用于高功率、多引线和大尺寸芯片,是替代AI2O3、BeO基板材料的最好材料。近年来AIN 陶瓷的研究受到世界各国的青睐,其研究与开发已经取得令人瞩目的进展。
虽然AIN陶瓷的应用前景十分广阔,但作为理想的基板材料,还存在着成本高,高温下难致密烧结,生产中的重复性差等问题。因此,如果能大幅度降低优质粉体的合成成本,引入合适的烧结助剂,实现在较低温度下致密烧结,稳定地获得高质量的流延基片,并解决其金属化的问题,它将在SIP领域获得越来越广泛的应用。
1.2 低温共烧陶瓷材料
低温共烧陶瓷(LowTemperature Co-fired Ceramic,LTCC)技术是近年来兴起的一种令人瞩目的多学科交叉的整合组件技术,因其优异的电子、热机械特性已成为未来电子组件集成化、模组化的首选方式。它采用厚膜材料,根据预先设计的结构,将电极材料、基板、电子器件等一次烧成,是一种实现SIP最有希望的电子封装技术。
LTCC采用低温烧结陶瓷粉料(800~900℃),根据预先设计的结构,通过流延工艺将陶瓷浆料制成厚度精确且致密的生瓷带,在生瓷带上利用激光打孔、微孔注浆、精密导体浆料印刷等工艺形成金属化布线和通孔金属化制成所需要的电路图形,然后将电极材料(Au、Ag、Ag/Pd和Cu)、基板、电子器件(如低容值电容、电阻、滤波器、阻抗转换器、耦合器等)等叠片后,在1000℃以下一次性烧成多层互连三维电路基板,在其表面可以贴装IC和有源器件,制成无源/有源集成的功能模块。
基于LTCC的SIP相比传统的SIP具有良好的高速、微波性能和极高的集成度。与其它集成技术相比,LTCC具有以下特点:可以实现各层分别设计、一体烧结,从而提高生产效率和成品率,降低了成本;独特的外导体、内导体以及导热通道设计,提高了散热效率,解决了散热难题;既实现各种无源元件(电阻、电容、电感、滤波器)的集成,又可表面贴装IC元件,提高了集成密度和功能化程度,减小了模块体积;可将不同介电常数(高ε、低ε)的微波介质材料集成以满足不同工作频率的要求,具有优良的高频、高Q特性。特别是,由于批量生产设备和工艺的引入,原材料成本降低以及在中国进行加工制造,LTCC产品的成本得以大幅度的降低;由于使用嵌入元件而不是线路板上的表面贴装元件,模块尺寸减小20%~40%,系统成本更低。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。